
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe ja Si selektiivne söövitustehnoloogia
Gate-All-Around FET (GAAFET), kui järgmise põlvkonna transistori arhitektuur, mis on valmis asendama FinFET-i, on pälvinud märkimisväärset tähelepanu selle võimele pakkuda paremat elektrostaatilist juhtimist ja paremat jõudlust väiksemate mõõtmetega. Kriitiline samm n-tüüpi GAAFET-ide valmistamisel hõlmab suurt selektiivsustsöövitusSiGe:Si virnadest enne sisemiste vahekihtide ladestamist, tekitades räni nanokihte ja vabastades kanaleid.

See artikkel käsitleb valikuidsöövitamise tehnoloogiadosaleb selles protsessis ja tutvustab kahte uudset söövitusmeetodit – suure oksüdatiivse gaasi plasmavaba söövitamist ja aatomkihi söövitamist (ALE), mis pakuvad uusi lahendusi SiGe söövitamise suure täpsuse ja selektiivsuse saavutamiseks.
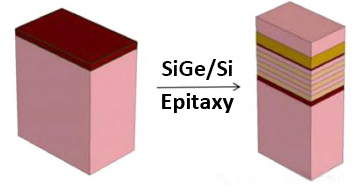
SiGe supervõrekihid GAA struktuurides
GAAFETide disainis kasutatakse seadme jõudluse parandamiseks vaheldumisi Si ja SiGe kihtekasvatatakse epitaksiaalselt ränisubstraadil, moodustades mitmekihilise struktuuri, mida nimetatakse supervõreks. Need SiGe kihid mitte ainult ei reguleeri kandja kontsentratsiooni, vaid parandavad ka elektronide liikuvust, tekitades stressi. Kuid järgmistes protsessietappides tuleb need SiGe kihid täpselt eemaldada, säilitades samal ajal ränikihid, mis nõuab väga selektiivseid söövitustehnoloogiaid.
SiGe selektiivse söövitamise meetodid
Suure oksüdatiivse gaasisisaldusega plasmavaba söövitus
ClF3 gaasi valik: see söövitusmeetod kasutab väga oksüdatiivseid gaase, millel on äärmine selektiivsus, nagu ClF3, mis saavutab SiGe:Si selektiivsuse suhte 1000–5000. Seda saab lõpetada toatemperatuuril plasmakahjustusi põhjustamata.
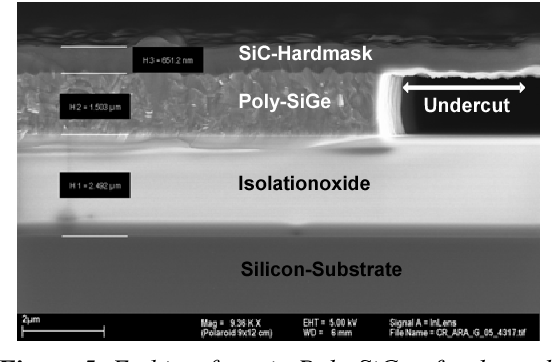
Tõhusus madalal temperatuuril: optimaalne temperatuur on umbes 30 °C, mis tagab kõrge selektiivsuse söövitamise madalatel temperatuuridel, vältides täiendavat soojuseelarve suurenemist, mis on seadme jõudluse säilitamiseks ülioluline.
Kuiv keskkond: kogusöövitusprotsessviiakse läbi täiesti kuivades tingimustes, välistades struktuuri nakkumise ohu.
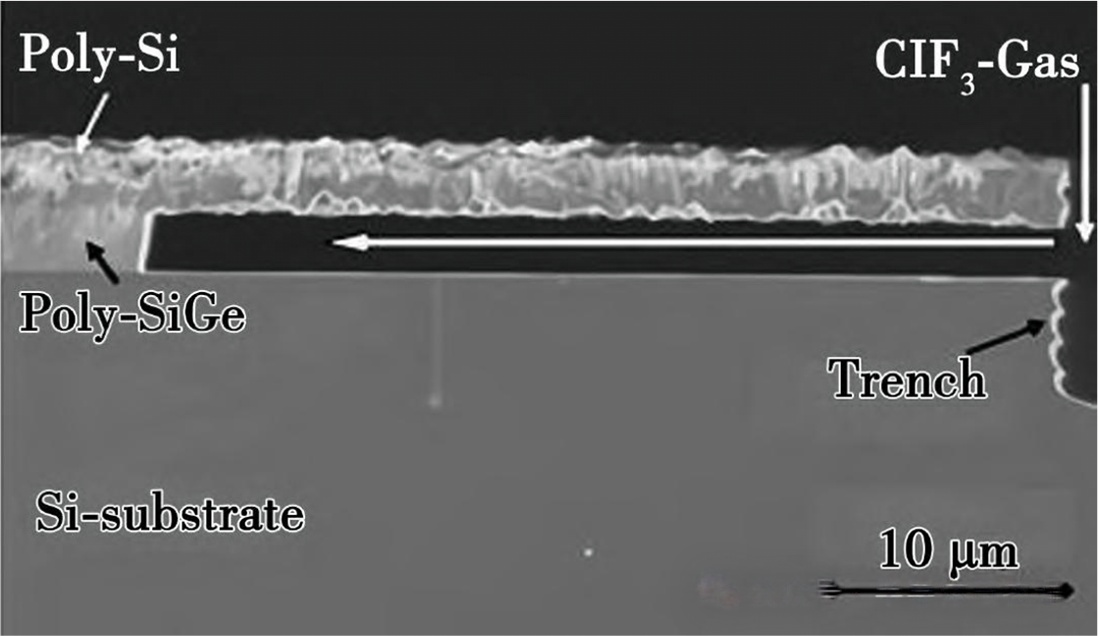
Aatomikihi söövitus (ALE)
Isepiiravad omadused: ALE on kaheastmeline tsükkelsöövitamise tehnoloogia, kus esmalt muudetakse söövitava materjali pinda ja seejärel eemaldatakse modifitseeritud kiht muutmata osi mõjutamata. Iga samm on isepiirav, tagades täpsuse kuni mõne aatomikihi korraga eemaldamise tasemeni.
Tsükliline söövitus: ülalmainitud kahte etappi korratakse korduvalt, kuni saavutatakse soovitud söövitussügavus. See protsess võimaldab ALE-l saavutadaaatomitaseme täppissöövitussiseseinte väikestes õõnsustes.

Meie, Semicorex, oleme spetsialiseerunudSiC/TaC kaetud grafiidilahusedmida kasutatakse pooljuhtide tootmises söövitusprotsessides, kui teil on küsimusi või vajate täiendavaid üksikasju, võtke meiega ühendust.
Kontakttelefon: +86-13567891907
E-post: sales@semicorex.com




