
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe kiibi tootmises: professionaalne uudistearuanne
Pooljuhtmaterjalide evolutsioon
Kaasaegse pooljuhttehnoloogia vallas on halastamatu tung miniaturiseerimise poole nihutanud traditsiooniliste ränipõhiste materjalide piire. Suure jõudluse ja väikese energiatarbimise nõuete täitmiseks on SiGe (ränigermaanium) oma ainulaadsete füüsikaliste ja elektriliste omaduste tõttu kujunenud pooljuhtkiipide valmistamisel komposiitmaterjaliks. See artikkel käsitlebepitaksia protsessSiGe ja selle rolli epitaksiaalses kasvus, pingestatud räni rakendustes ja Gate-All-Around (GAA) struktuurides.
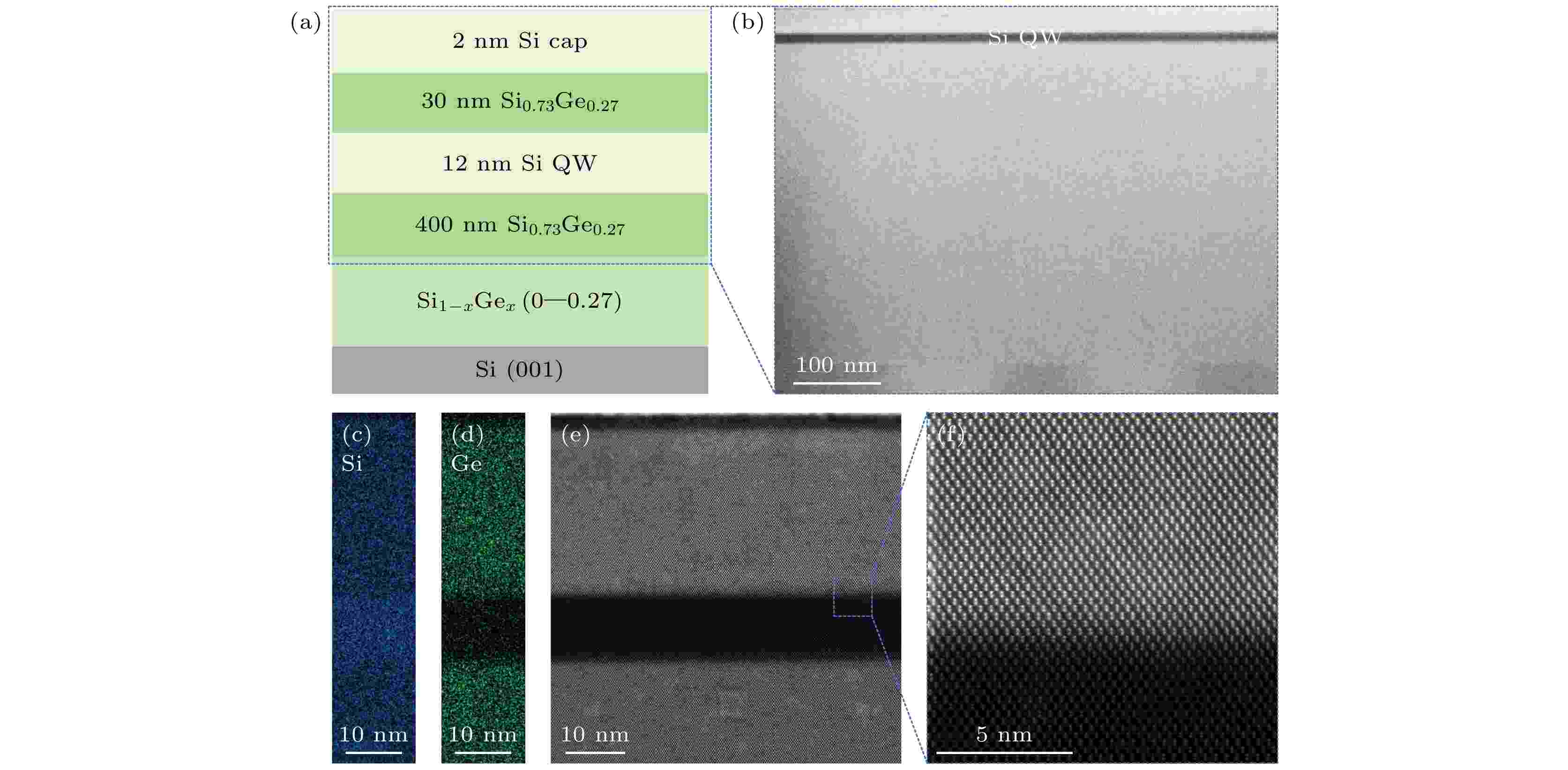
SiGe epitaktika tähtsus
1.1 Sissejuhatus Epitaxysse kiibi tootmises:
Epitaksia, mida sageli lühendatakse kui Epi, viitab ühekristallilise kihi kasvamisele ühekristallilisel substraadil, millel on sama võre paigutus. See kiht võib olla kashomoepitaksiaalne (nagu Si/Si)või heteroepitaksiaalne (nagu SiGe/Si või SiC/Si). Epitaksiaalseks kasvuks kasutatakse erinevaid meetodeid, sealhulgas molekulaarkiirepitaksia (MBE), ülikõrge vaakum-keemiline aurustamine-sadestamine (UHV/CVD), atmosfääri- ja alandatud rõhu epitaksia (ATM & RP Epi). See artikkel keskendub räni (Si) ja räni-germaaniumi (SiGe) epitaksiprotsessidele, mida kasutatakse laialdaselt pooljuhtide integraallülituste tootmisel, kasutades substraadimaterjalina räni.
1.2 SiGe Epitaxy eelised:
Sisaldab teatud osa germaaniumi (Ge) ajalepitaksia protsessmoodustab SiGe ühekristallkihi, mis mitte ainult ei vähenda ribalaiust, vaid suurendab ka transistori piirsagedust (fT). See muudab selle laialdaselt kasutatavaks traadita ja optilise side kõrgsagedusseadmetes. Veelgi enam, täiustatud CMOS-i integraallülitusprotsessides põhjustab Ge ja Si vaheline võre mittevastavus (umbes 4%) võre pinget, suurendades elektronide või aukude liikuvust ja suurendades seega seadme küllastusvoolu ja reageerimiskiirust.
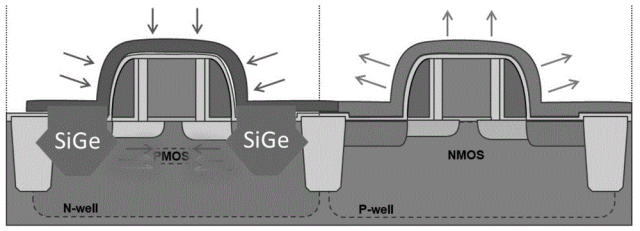
SiGe'i kõikehõlmav epitaksiprotsessi voog
2.1 Eeltöötlus:
Ränivahvleid eeltöödeldakse vastavalt soovitud protsessi tulemustele, mis hõlmab peamiselt loodusliku oksiidikihi ja mustuse eemaldamist vahvli pinnalt. Tugevalt legeeritud substraatvahvlite puhul on ülioluline kaaluda, kas tagatihendamine on vajalik, et vähendada automaatset dopingut järgnevatel aegadel.epitaksia kasv.
2.2 Kasvugaasid ja tingimused:
Ränigaasid: silaan (SiH₂), diklorosilaan (DCS, SiH₂Cl₂) ja triklorosilaan (TCS, SiHCl3) on kolm kõige sagedamini kasutatavat ränigaasi allikat. SiH₄ sobib madalatemperatuurilisteks täisepitaksilisteks protsessideks, samas kui kiire kasvukiiruse poolest tuntud TCS-i kasutatakse laialdaselt paksude kihtide valmistamiseks.räni epitaksiakihid.
Germaaniumigaas: Germane (GeH₄) on esmane germaaniumi lisamise allikas, mida kasutatakse koos räniallikatega SiGe sulamite moodustamiseks.
Selektiivne epitaksia: selektiivne kasv saavutatakse suhteliste määrade reguleerimisegaepitaksiaalne ladestumineja in situ söövitamine, kasutades kloori sisaldavat ränigaasi DCS-i. Selektiivsus tuleneb Cl-aatomite adsorptsioonist räni pinnal, mis on väiksem kui oksiididel või nitriididel, hõlbustades epitaksiaalset kasvu. SiH₄, millel puuduvad Cl-aatomid ja millel on madal aktiveerimisenergia, kasutatakse tavaliselt ainult madala temperatuuriga täielike epitaksia protsesside jaoks. Teisel tavaliselt kasutataval räniallikal, TCS-il, on madal aururõhk ja see on toatemperatuuril vedel, mis nõuab H2 mullitamist, et see reaktsioonikambrisse viia. Kuid see on suhteliselt odav ja seda kasutatakse sageli selle kiire kasvukiiruse (kuni 5 μm / min) tõttu paksemate räni epitaksiliste kihtide kasvatamiseks, mida kasutatakse laialdaselt räni epitaksia vahvlite tootmisel.
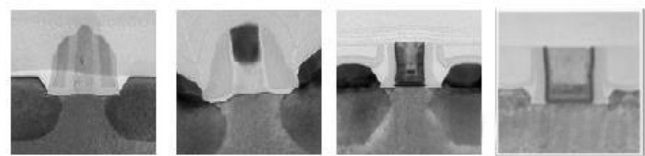
Pingutatud räni epitaksiaalsetes kihtides
ajalepitaksiaalne kasv, epitaksiaalne ühekristalliline Si sadestatakse lõdvestunud SiGe kihile. Si ja SiGe vahelise võre mittevastavuse tõttu on Si ühekristalliline kiht allutatud selle aluseks oleva SiGe kihi tõmbepingele, mis suurendab oluliselt elektronide liikuvust NMOS-transistorides. See tehnoloogia mitte ainult ei suurenda küllastusvoolu (Idsat), vaid parandab ka seadme reageerimiskiirust. PMOS-seadmete puhul kasvatatakse pärast söövitamist SiGe kihte epitaksiaalselt lähte- ja äravoolupiirkondades, et tekitada kanalile survepinget, suurendades aukude liikuvust ja suurendades küllastusvoolu.
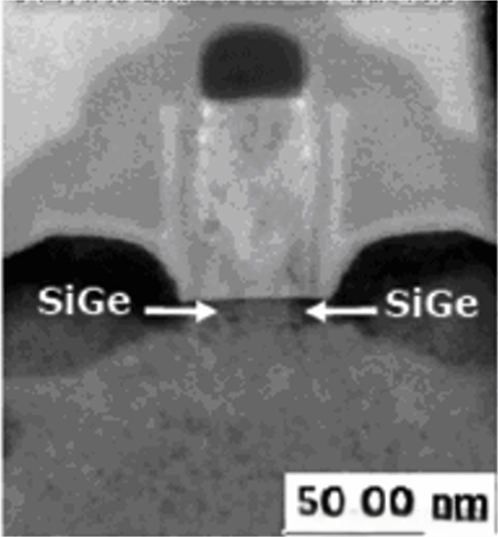
SiGe kui ohverduskiht GAA struktuurides
Gate-All-Around (GAA) nanojuhtmetransistoride valmistamisel toimivad SiGe kihid ohverduskihtidena. Kõrge selektiivsusega anisotroopsed söövitusmeetodid, nagu kvaasi-aatomikihi söövitus (kvaasi-ALE), võimaldavad SiGe kihtide täpset eemaldamist, et moodustada nanotraat- või nanolehtstruktuure.
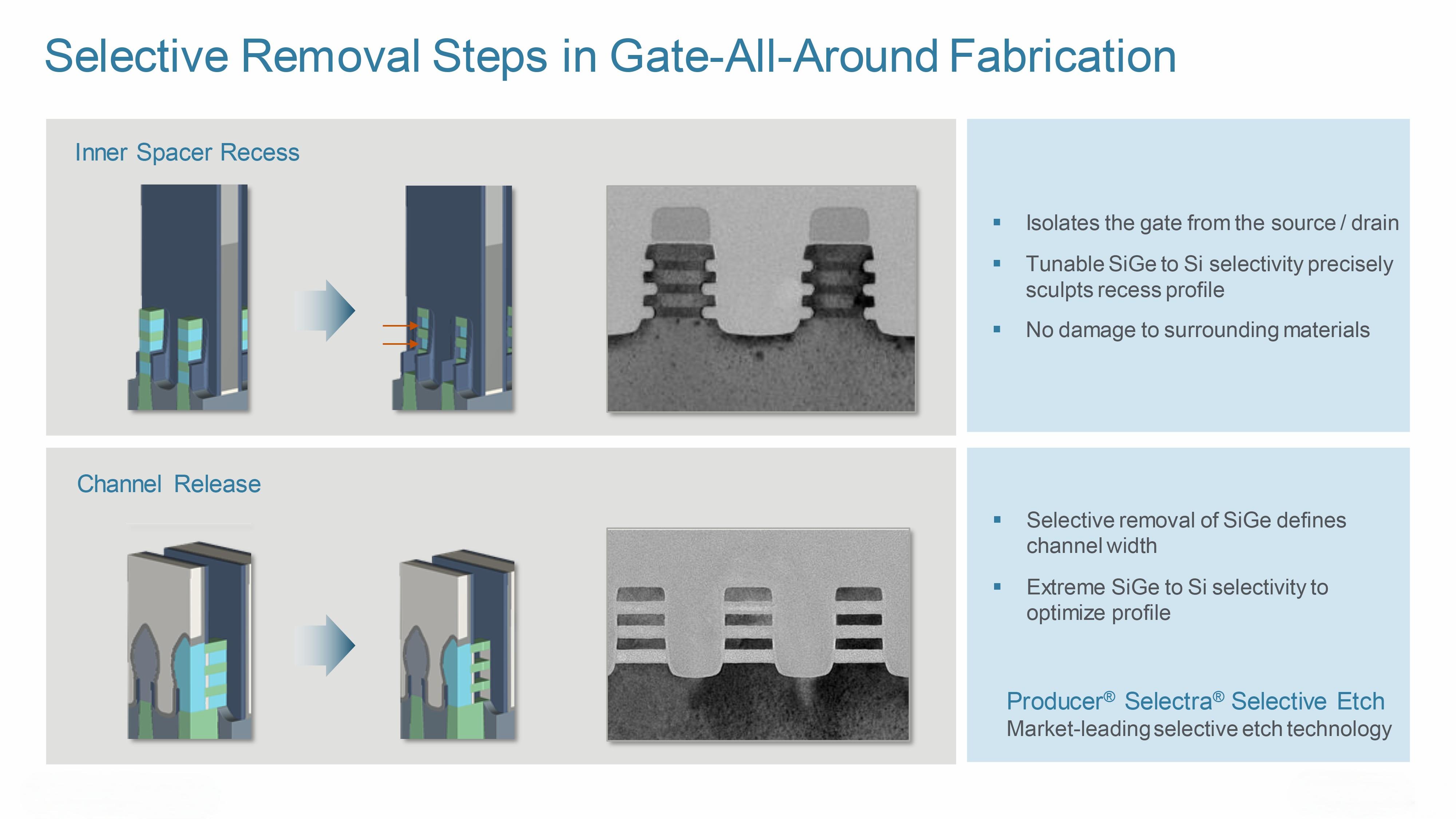
Meie, Semicorex, oleme spetsialiseerunudSiC/TaC kaetud grafiidilahusedkasutatakse Si epitaksiaalses kasvus pooljuhtide tootmises, kui teil on küsimusi või vajate täiendavaid üksikasju, võtke meiega ühendust.
Kontakttelefon: +86-13567891907
E-post: sales@semicorex.com




