
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Täieliku pooljuhtseadmete valmistamise protsessi mõistmine
1. Fotolitograafia
Fotolitograafia, mis on sageli sünonüümiks mustrite genereerimisele, on pooljuhttehnoloogia kiire arengu üks kriitilisemaid tõukejõude, mis tuleneb trükkimisel kasutatavatest fotograafiliste plaatide valmistamise protsessidest. See tehnika võimaldab esitada mis tahes mustreid mikro- või nanomõõtmetes. fotoresist ja kombineerituna teiste protsessitehnoloogiatega kannab need mustrid materjalidele, realiseerides pooljuhtmaterjalide ja -seadmete erinevaid kujundusi ja kontseptsioone. Fotolitograafias kasutatav valgusallikas mõjutab otseselt mustrite täpsust, valikuvõimalused ulatuvad ultraviolettkiirgusest, sügavast ultraviolettkiirgusest kuni röntgeni- ja elektronkiirteni, millest igaüks vastab mustri täpsuse suurenemisele mainitud järjekorras.
Standardne fotolitograafia protsessi voog hõlmab pinna ettevalmistamist, adhesiooni, pehmet küpsetamist, säritamist, säritamisjärgset küpsetamist, arendust, kõva küpsetamist ja kontrolli.
Pinnatöötlus on hädavajalik, kuna substraadid imavad tavaliselt õhust H2O molekule, mis on fotolitograafiale kahjulik. Seetõttu läbivad substraadid algselt küpsetamise kaudu dehüdratsiooni.
Hüdrofiilsete substraatide puhul on nende adhesioon hüdrofoobse fotoresistiga ebapiisav, mis võib põhjustada fotoresisti eraldumist või mustri nihkumist, seega on vaja adhesioonipromootorit. Praegu on adhesioonivõimendajad laialdaselt kasutatavad heksametüüldisilasaan (HMDS) ja tri-metüülsilüüldietüülamiin (TMSDEA).
Pärast pinnatöötlust algab fotoresisti pealekandmine. Kasutatava fotoresisti paksus ei ole seotud ainult selle viskoossusega, vaid seda mõjutab ka tsentrifuugimise kiirus, mis on üldiselt pöördvõrdeline pöörlemiskiiruse ruutjuurega. Pärast katmist viiakse läbi pehme küpsetus, et aurustada lahusti fotoresistist, parandades nakkumist protsessis, mida nimetatakse eelküpsetamiseks.
Kui need sammud on lõpule viidud, toimub kokkupuude. Fotoresistid liigitatakse positiivseteks või negatiivseteks, millel on pärast kokkupuudet vastupidised omadused.
Võtke näiteks positiivne fotoresist, kus säritamata fotoresist ei lahustu ilmutis, kuid muutub pärast kokkupuudet lahustuvaks. Särituse ajal valgustab mustriga maski läbiv valgusallikas kaetud substraati, kujundades fotoresisti mustri. Tavaliselt tuleb aluspind enne kokkupuudet maskiga joondada, et säritusasendit täpselt kontrollida. Mustri moonutamise vältimiseks tuleb kokkupuute kestust rangelt reguleerida. Pärast kokkupuudet võib seisulaine mõju leevendamiseks olla vaja täiendavat küpsetamist, kuigi see samm on valikuline ja sellest võib otsese arendamise kasuks mööda minna. Areng lahustab säritatud fotoresisti, kandes maski mustri täpselt fotoresisti kihile. Arendusaeg on samuti kriitiline - liiga lühike viib mittetäieliku arenguni, liiga pikk põhjustab mustri moonutamist.
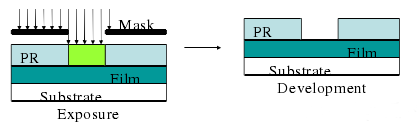
Seejärel tugevdab kõva küpsetamine fotoresistkile kinnitust aluspinnale ja parandab selle söövituskindlust. Kõva küpsetustemperatuur on üldiselt veidi kõrgem kui eelküpsetus.
Lõpuks kontrollib mikroskoopiline kontroll, kas muster vastab ootustele. Pärast mustri kandmist materjalile muude protsesside abil on fotoresist oma eesmärgi täitnud ja see tuleb eemaldada. Eemaldamismeetodite hulka kuuluvad märg (kasutatakse tugevaid orgaanilisi lahusteid, nagu atsetoon) ja kuiv (hapnikuplasma kasutamine kile söövitamiseks).
2. Dopingutehnikad
Doping on pooljuhttehnoloogias asendamatu, muutes vastavalt vajadusele pooljuhtmaterjalide elektrilisi omadusi. Levinud dopingumeetodid hõlmavad termilist difusiooni ja ioonide implanteerimist.
(1) Ioonide implantatsioon
Ioonide implanteerimine dopistab pooljuhtsubstraati, pommitades seda suure energiaga ioonidega. Võrreldes termilise difusiooniga on sellel palju eeliseid. Massanalüsaatoriga valitud ioonid tagavad kõrge dopingupuhtuse. Kogu implantatsiooni ajal püsib substraat toatemperatuuril või veidi kõrgemal. Kasutada saab paljusid maskeerivaid kilesid, nagu ränidioksiidi (SiO2), räninitriid (Si3N4) ja fotoresisti, mis tagab suure paindlikkuse isejoonduvate maskitehnikatega. Implantaadi annuseid kontrollitakse täpselt ja implanteeritud lisandite ioonide jaotus on samal tasapinnal ühtlane, mille tulemuseks on kõrge korratavus.
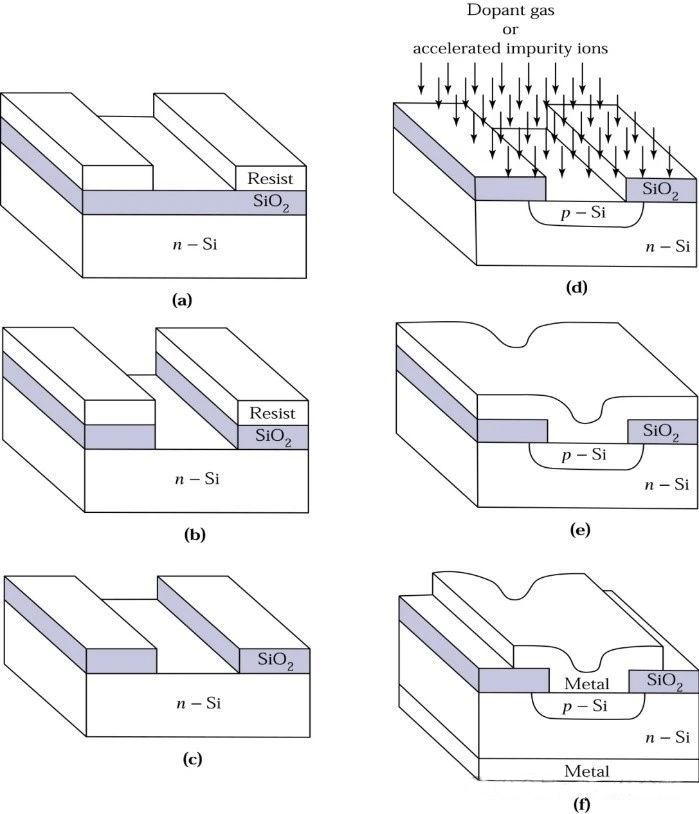
Implantatsiooni sügavuse määrab ioonide energia. Energia ja doosi reguleerimisega saab manipuleerida lisandiioonide jaotumist substraadis pärast implanteerimist. Erinevate lisandite profiilide saavutamiseks võib pidevalt teostada mitut erinevate skeemidega implanteerimist. Eelkõige ilmnevad ühekristallilistes substraatides, kui implantatsiooni suund on kristallograafilise suunaga paralleelne, kanalisatsiooniefektid - mõned ioonid liiguvad mööda kanaleid, muutes sügavuse kontrolli keeruliseks.
Kanalistumise vältimiseks viiakse implanteerimine tavaliselt läbi umbes 7° nurga all ühekristallilise substraadi peatelje suhtes või kattes substraadi amorfse kihiga.
Ioonide implanteerimine võib aga oluliselt kahjustada substraadi kristallstruktuuri. Suure energiaga ioonid kannavad kokkupõrkel energiat substraadi tuumadele ja elektronidele, pannes need võrest lahkuma ja moodustama interstitsiaalse-vakantsi defektide paare. Rasketel juhtudel võib kristallstruktuur mõnes piirkonnas hävida, moodustades amorfsed tsoonid.
Võre kahjustused mõjutavad suuresti pooljuhtmaterjali elektrilisi omadusi, näiteks vähendavad kandja liikuvust või mittetasakaaluliste kandjate eluiga. Kõige tähtsam on see, et enamik implanteeritud lisanditest hõivavad ebaregulaarsed interstitsiaalsed kohad, mis ei suuda moodustada tõhusat dopingut. Seetõttu on implantatsioonijärgse võre kahjustuse parandamine ja lisandite elektriline aktiveerimine hädavajalikud.
(2)Kiire termiline töötlemine (RTP)
Termiline lõõmutamine on kõige tõhusam meetod ioonide siirdamisest ja elektriliselt aktiveerivatest lisanditest põhjustatud võrekahjustuste parandamiseks. Kõrgetel temperatuuridel substraadi kristallvõre interstitsiaalsed-vakantsed defektide paarid rekombineeruvad ja kaovad; amorfsed piirkonnad kristalliseeruvad ümber ka ühekristalliliste alade piirilt tahkefaasilise epitaksia kaudu. Et vältida alusmaterjali oksüdeerumist kõrgel temperatuuril, tuleb termiline lõõmutamine läbi viia vaakumis või inertgaasi atmosfääris. Traditsiooniline lõõmutamine võtab kaua aega ja võib difusiooni tõttu põhjustada märkimisväärset lisandite ümberjaotumist.
TulekRTP tehnoloogiategeleb selle probleemiga, saavutades suures osas võrekahjustuste parandamise ja lisandite aktiveerimise lühendatud lõõmutamise kestuse jooksul.
Sõltuvalt soojusallikast,RTPliigitatakse mitmeks tüübiks: elektronkiire skaneerimine, impulss-elektron- ja ioonkiired, impulsslaserid, pidevlaine laserid ja lairiba mittekoherentsed valgusallikad (halogeenlambid, grafiitküttekehad, kaarlambid), kusjuures viimaseid kasutatakse kõige laialdasemalt. Need allikad võivad kuumutada substraadi hetkega vajaliku temperatuurini, viies lõõmutamise lühikese aja jooksul lõpule ja vähendades tõhusalt lisandite difusiooni.
3. Kile sadestamise tehnikad
(1) Plasma-Enhanced Chemical Vapor Deposition (PECVD)
PECVD on keemilise aurustamise-sadestamise (CVD) tehnika üks vorme kile sadestamiseks, ülejäänud kaks on atmosfäärirõhu CVD (APCVD) ja madalrõhu CVD (LPCVD).
Praegu on PECVD kolmest tüübist kõige laialdasemalt kasutatav. See kasutab raadiosageduslikku (RF) plasmat keemiliste reaktsioonide algatamiseks ja säilitamiseks suhteliselt madalatel temperatuuridel, hõlbustades seega kõrge sadestuskiirusega madala temperatuuriga kile sadestumist. Selle varustuse skeem on näidatud joonisel.
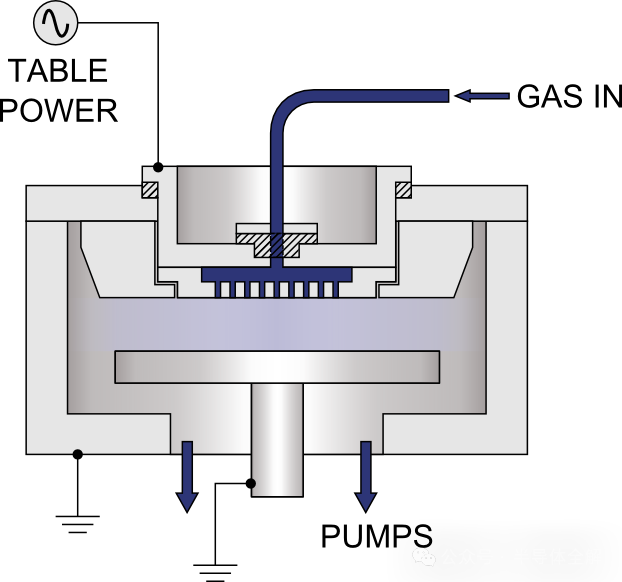
Selle meetodi abil toodetud kiledel on erakordsed adhesiooni- ja elektriomadused, minimaalne mikropoorsus, kõrge ühtlus ja tugev väikesemahuline täitmisvõime. PECVD sadestumise kvaliteeti mõjutavad tegurid hõlmavad substraadi temperatuuri, gaasi voolukiirust, rõhku, raadiosageduslikku võimsust ja sagedust.
(2) Pritsimine
Pihustamine on füüsikalise aurustamise-sadestamise (PVD) meetod. Laetud ioonid (tavaliselt argooniioonid, Ar+) kiirendatakse elektriväljas, saades kineetilise energia. Need on suunatud sihtmaterjali poole, põrkuvad kokku sihtmolekulidega ja põhjustavad nende paigast nihkumise ja pritsimise. Nendel molekulidel on ka märkimisväärne kineetiline energia ja nad liiguvad substraadi poole, ladestuvad sellele.

Tavaliselt kasutatavad pihustusjõuallikad hõlmavad alalisvoolu (DC) ja raadiosagedust (RF), kus alalisvoolu pihustamine on otseselt rakendatav juhtivate materjalide, näiteks metallide puhul, samas kui isolatsioonimaterjalid nõuavad kile sadestamiseks raadiosageduslikku pihustust.
Tavaline pihustamine kannatab madala sadestuskiiruse ja kõrge töörõhu tõttu, mille tulemuseks on madalam kile kvaliteet. Magnetroni pihustamine lahendab need probleemid ideaalsemalt. See kasutab välist magnetvälja, et muuta ioonide lineaarset trajektoori spiraalseks teeks ümber magnetvälja suuna, pikendades nende teed ja parandades kokkupõrke efektiivsust sihtmolekulidega, suurendades seeläbi pihustamise efektiivsust. Selle tulemuseks on suurenenud sadestuskiirus, vähenenud töörõhk ja oluliselt paranenud kile kvaliteet.
4. Söövitus Tehnikad
Söövitus liigitatakse kuivaks ja märjaks režiimiks, mis on nimetatud vastavalt konkreetsete lahenduste kasutamise (või puudumise) järgi.
Tavaliselt nõuab söövitus maskikihi (mis võib olla otse fotoresist) ettevalmistamist, et kaitsta söövitamiseks mitte ette nähtud piirkondi.
(1) Kuivsöövitamine
Levinud kuivsöövitamise tüübid hõlmavadInduktiivselt sidestatud plasma (ICP) söövitus, Ion Beam Etching (IBE) ja Reactive Ion Etching (RIE).
ICP söövitamisel sisaldab hõõglahendusega toodetud plasma arvukalt keemiliselt väga aktiivseid vabu radikaale (vabu aatomeid, molekule või aatomrühmi), mis reageerivad keemiliselt sihtmaterjaliga, moodustades lenduvaid tooteid, saavutades seega söövituse.
IBE kasutab suure energiaga ioone (ioniseeritud inertgaasidest), et pommitada otse sihtmaterjali pinda söövitamiseks, mis kujutab endast füüsilist protsessi.
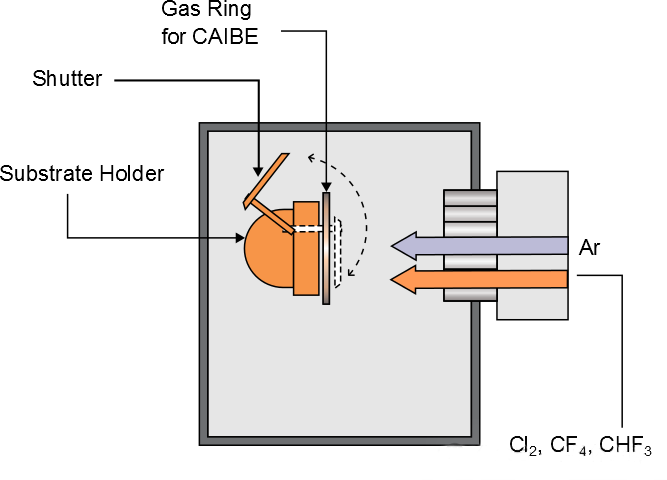
RIE-d peetakse kahe eelmise kombinatsiooniks, mis asendab IBE-s kasutatud inertgaasi ICP söövitamisel kasutatava gaasiga, moodustades seeläbi RIE.
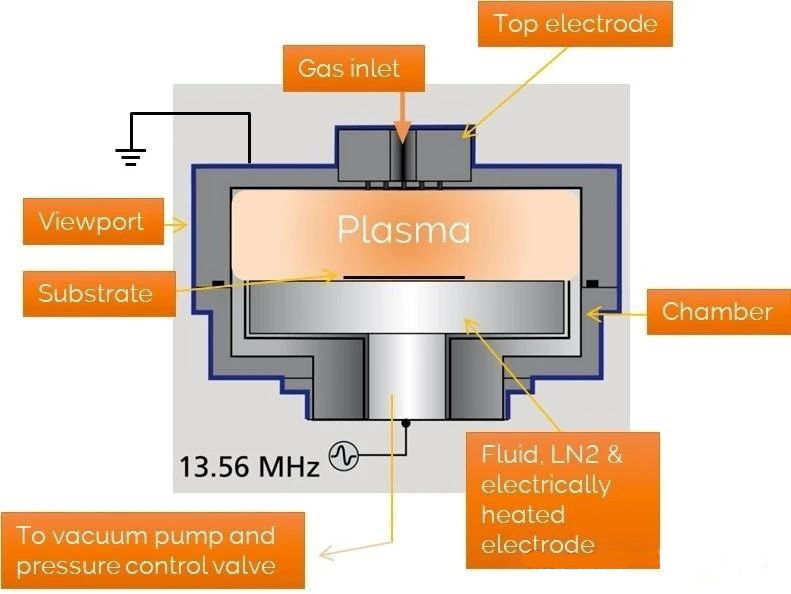
Kuivsöövitamise korral ületab vertikaalne söövituskiirus tunduvalt külgmist kiirust, st sellel on kõrge kuvasuhe, mis võimaldab maski mustri täpset replikatsiooni. Kuivsöövitus söövitab aga ka maskikihti, näidates kehvemat selektiivsust (sihtmaterjali söövituskiiruste suhe maskikihisse), eriti IBE puhul, mis võib mitteselektiivselt kogu materjali pinnale söövitada.
(2) Märgsöövitus
Märgsöövitamine tähistab söövitusmeetodit, mis saavutatakse sihtmaterjali sukeldamisega lahusesse (söövitusaine), mis reageerib sellega keemiliselt.
See söövitusmeetod on lihtne, kulutõhus ja sellel on hea selektiivsus, kuid sellel on madal kuvasuhe. Maski servade all olev materjal võib olla korrodeerunud, muutes selle vähem täpseks kui kuivsöövitus. Madala kuvasuhte negatiivsete mõjude leevendamiseks tuleb valida sobivad söövituskiirused. Söövituskiirust mõjutavad tegurid hõlmavad söövitusaine kontsentratsiooni, söövitusaega ja söövitusaine temperatuuri.**




