
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Kuivsöövitamise tehnoloogia mõistmine pooljuhtide tööstuses
Söövitamine viitab materjali valikulise eemaldamise tehnikale füüsikaliste või keemiliste vahenditega, et saavutada kavandatud struktuurimustrid.
Praegu kasutavad paljud pooljuhtseadmed mesa-seadme struktuure, mis on loodud valdavalt kahte tüüpi söövitamise teel:märgsöövitus ja kuivsöövitamine. Kuigi lihtne ja kiire märgsöövitus mängib pooljuhtseadmete valmistamisel olulist rolli, on sellel omased puudused, nagu isotroopne söövitamine ja halb ühtlus, mille tulemuseks on piiratud kontroll väikese suurusega mustrite ülekandmisel. Kuivsöövitamine on aga oma kõrge anisotroopsuse, hea ühtluse ja korratavusega muutunud pooljuhtseadmete valmistamise protsessides silmapaistvaks. Termin "kuivsöövitus" viitab üldjoontes mis tahes mittemärgsöövitamise tehnoloogiale, mida kasutatakse pinnamaterjalide eemaldamiseks ning mikro- ja nanomustrite ülekandmiseks, sealhulgas lasersöövitus, plasmasöövitus ja keemiline auruga söövitamine. Selles tekstis käsitletav kuivsöövitamine puudutab konkreetselt selliste protsesside kitsast rakendamist, mis kasutavad plasmalahendust – kas füüsikalist või keemilist – materjali pindade muutmiseks. See hõlmab mitmeid levinud tööstuslikke söövitustehnoloogiaid, sealhulgasIoonkiirega söövitus (IBE), reaktiivse iooni söövitus (RIE), elektrontsüklotronresonantsi (ECR) plasmasöövitus ja induktiivselt sidestatud plasma (ICP) söövitus.
1. Ioonkiirega söövitus (IBE)
Tuntud ka kui ioonjahvatamine, töötati IBE välja 1970. aastatel puhtalt füüsilise söövitusmeetodina. Protsess hõlmab inertgaasidest (nagu Ar, Xe) tekitatud ioonkiire, mida kiirendab pinge, et pommitada sihtmaterjali pinda. Ioonid kannavad energiat pinnaaatomitele, pannes need, mille energia ületab sidumisenergiat, minema pritsima. See meetod kasutab ioonkiire suuna ja energia juhtimiseks kiirendatud pinget, mille tulemuseks on suurepärane söövitamise anisotroopia ja kiiruse kontrollitavus. Kuigi see sobib ideaalselt keemiliselt stabiilsete materjalide, näiteks keraamika ja teatud metallide söövitamiseks, võib vajadus paksemate maskide järele sügavamate söövituste jaoks kahjustada söövitamise täpsust ja suure energiaga ioonidega pommitamine võib võre katkestuste tõttu põhjustada vältimatuid elektrikahjustusi.

2. Reaktiivne ioonide söövitamine (RIE)
IBE-st välja töötatud RIE ühendab keemilised reaktsioonid füüsikaliste ioonide pommitamisega. Võrreldes IBE-ga pakub RIE suuremat söövituskiirust ning suurepärast anisotroopiat ja ühtlust suurtel aladel, muutes selle üheks kõige laialdasemalt kasutatavaks söövitusmeetodiks mikro- ja nanotootmises. Protsess hõlmab raadiosagedusliku (RF) pinge rakendamist paralleelsetele plaatide elektroodidele, mille tulemusena kambris olevad elektronid kiirendavad ja ioniseerivad reaktsioonigaase, mis viib stabiilse plasma olekuni plaatide ühel küljel. Plasma kannab positiivset potentsiaali, kuna elektronid tõmbavad katoodi külge ja on maandatud anoodil, luues seega elektrivälja läbi kambri. Positiivselt laetud plasma kiireneb katoodiga seotud substraadi suunas, söövitades seda tõhusalt.
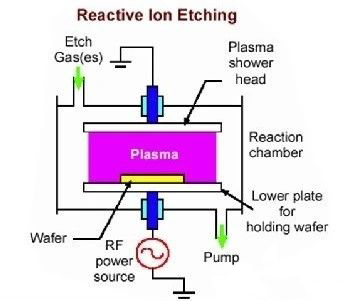
Söövitusprotsessi ajal hoiab kamber madala rõhuga keskkonda (0,1-10 Pa), mis suurendab reaktsioonigaaside ionisatsioonikiirust ja kiirendab keemilise reaktsiooni protsessi substraadi pinnal. Üldiselt nõuab RIE protsess, et reaktsiooni kõrvalsaadused oleksid lenduvad, et need saaksid vaakumsüsteemiga tõhusalt eemaldada, tagades söövitamise suure täpsuse. RF võimsustase määrab otseselt plasma tiheduse ja kiirenduse nihkepinge, kontrollides seeläbi söövituskiirust. Plasma tiheduse suurendamise ajal suurendab RIE aga ka eelpinget, mis võib põhjustada võre kahjustusi ja vähendada maski selektiivsust, piirates seega söövitusrakendusi. Suuremahuliste integraallülituste kiire arengu ja transistoride suuruse vähenemise tõttu on mikro- ja nanotootmises suurenenud nõudlus täpsuse ja kuvasuhte järele, mis on viinud suure tihedusega plasmapõhiste kuivsöövitamise tehnoloogiate tulekuni, pakkudes uusi võimalusi elektroonilise infotehnoloogia arendamiseks.
3. Electron Cyclotron Resonance (ECR) plasmasöövitus
ECR-tehnoloogia, varane meetod suure tihedusega plasma saavutamiseks, kasutab mikrolaineenergiat kambris olevate elektronidega resoneerimiseks, mida täiustab väliselt rakendatud sagedusega sobitatud magnetväli, et kutsuda esile elektrontsüklotroni resonants. Selle meetodiga saavutatakse oluliselt suurem plasmatihedus kui RIE-ga, suurendades söövituskiirust ja maski selektiivsust, hõlbustades seega ülikõrge kuvasuhtega struktuuride söövitamist. Süsteemi keerukus, mis tugineb mikrolaineallikate, RF-allikate ja magnetväljade koordineeritud funktsioonidele, seab aga tööprobleemid. Peagi järgnes induktiivselt sidestatud plasma (ICP) söövitamise tekkimine kui ECR lihtsustus.
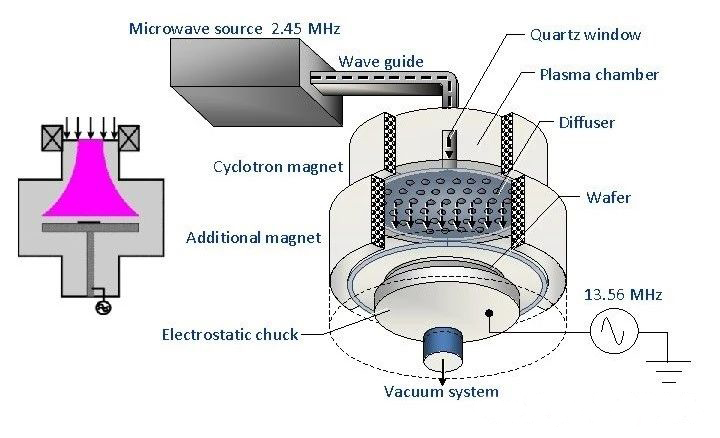
4. Induktiivselt sidestatud plasma (ICP) söövitus
ICP söövitustehnoloogia lihtsustab ECR-tehnoloogial põhinevat süsteemi, kasutades kahte 13,56 MHz RF-allikat nii plasma genereerimise kui ka kiirenduse eelpinge juhtimiseks. ECR-is kasutatava välise magnetvälja asemel indutseerib spiraalmähis vahelduva elektromagnetvälja, nagu on näidatud skeemil. RF-allikad edastavad energiat elektromagnetilise sidestuse kaudu sisemistele elektronidele, mis liiguvad indutseeritud väljas tsüklotroni liikumisel, põrkudes kokku reaktsioonigaasidega, põhjustades ionisatsiooni. Selle seadistuse abil saavutatakse plasma tihedus, mis on võrreldav ECR-ga. ICP söövitus ühendab erinevate söövitussüsteemide eelised, rahuldades kõrge söövituskiiruse, suure selektiivsuse, suure ala ühtluse ja lihtsa, juhitava seadmestruktuuri, muutudes seega kiiresti eelistatud valikuks uue põlvkonna suure tihedusega plasmasöövitustehnoloogiate jaoks. .
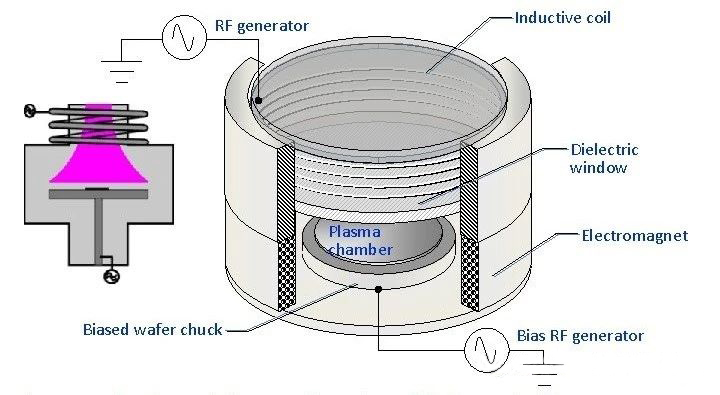
5. Kuivsöövituse omadused
Kuivsöövitamise tehnoloogia on tänu oma suurepärasele anisotroopiale ja kõrgele söövituskiirusele võtnud kiiresti peamise positsiooni mikro- ja nanotootmises, asendades märgsöövituse. Hea kuivsöövitustehnoloogia hindamise kriteeriumid hõlmavad maski selektiivsust, anisotroopiat, söövituskiirust, üldist ühtlust ja pinna siledust võrekahjustuste tõttu. Paljude hindamiskriteeriumide puhul tuleb konkreetset olukorda arvestada valmistamisvajadustest lähtuvalt. Kuivsöövituse kõige otsesemad näitajad on pinna morfoloogia, sealhulgas söövitatud põranda ja külgseinte tasasus ning söövitatud terrasside anisotroopsus, mida saab mõlemat kontrollida keemiliste reaktsioonide ja füüsikalise pommitamise suhte reguleerimisega. Mikroskoopiline iseloomustamine pärast söövitamist tehakse tavaliselt skaneeriva elektronmikroskoopia ja aatomjõumikroskoopia abil. Maski selektiivsus, mis on maski söövitussügavuse ja materjali söövitussügavuse suhe samadel söövitustingimustel ja aja jooksul, on ülioluline. Üldiselt, mida suurem on selektiivsus, seda parem on mustri ülekande täpsus. ICP-söövitamisel kasutatavad tavalised maskid hõlmavad fotoresist, metallid ja dielektrilised kiled. Fotoresist on halva selektiivsusega ja võib laguneda kõrgete temperatuuride või energilise pommitamise mõjul; metallid pakuvad suurt selektiivsust, kuid kujutavad endast väljakutseid maski eemaldamisel ja nõuavad sageli mitmekihilist maskeerimistehnikat. Lisaks võivad metallmaskid söövitamise ajal külgseintele kleepuda, moodustades lekketeid. Seetõttu on söövitamisel eriti oluline sobiva maskitehnoloogia valimine ning maskimaterjalide valikul tuleks lähtuda seadmete spetsiifilistest jõudlusnõuetest.**




