
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Plasmaprotsessid CVD operatsioonides
1. Kambri puhastamine
Keemilise aurustamise-sadestamise (CVD) käigus ei teki sadestused mitte ainult vahvli pinnale, vaid ka protsessikambris ja selle seintes olevatele komponentidele. Osadele ladestunud kiled tuleb korrapäraselt eemaldada, et säilitada stabiilsed protsessitingimused ja vältida vahvlite osakestega saastumist. Enamikus CVD-kambrites kasutatakse puhastamiseks fluoripõhiseid keemilisi reaktsioonigaase.
Ränioksiidi CVD-kambrites hõlmab plasmapuhastus tavaliselt fluorosüsivesinikgaase, nagu CF4, C2F6 ja C3F8, mis lagunevad plasmas, vabastades fluoriradikaale. Keemilised reaktsioonid on esitatud järgmiselt:
·e- + CF4 -> CF3 + F + e-
· e- + C2F6 -> C2F5 + F + e-
Fluori aatomid, mis on ühed kõige reaktiivsemad radikaalid, reageerivad kiiresti ränioksiidiga, moodustades gaasilise SiF4, mida saab kambrist kergesti evakueerida:
·F + SiO2 -> SiF4 + O2 + muud lenduvad kõrvalsaadused
Volfram-CVD-kambrites kasutatakse tavaliselt fluoriallikatena SF6 ja NF3. Fluoriradikaalid reageerivad volframiga, tekitades lenduvat volframheksafluoriidi (WF6), mida saab kambrist vaakumpumpade abil evakueerida. Plasmakambri puhastamise saab automaatselt lõpetada, jälgides plasmas leiduva fluori emissiooni karakteristikuid, vältides kambri liigset puhastamist. Neid aspekte arutatakse üksikasjalikumalt.
2. Tühikute täitmine
Kui metalljoonte vahe kitseneb 0,25 µm-ni kuvasuhtega 4:1, on enamikul CVD-sadestamise tehnikatel raskusi tühimike täitmisel. High-Density Plasma CVD (HDP-CVD) on võimeline täitma sellised kitsad tühimikud ilma tühimikke tekitamata (vt joonist allpool). HDP-CVD protsessi kirjeldatakse edaspidi.
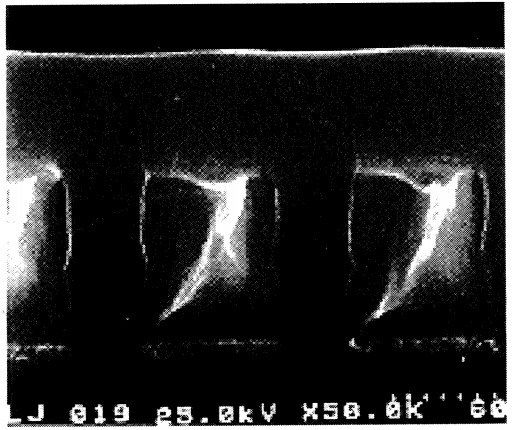
3. Plasma söövitamine
Võrreldes märgsöövitusega pakub plasmasöövitus selliseid eeliseid nagu anisotroopsed söövitusprofiilid, automaatne lõpp-punkti tuvastamine ja väiksem kemikaalide tarbimine koos mõistliku kõrge söövituskiiruse, hea selektiivsuse ja ühtlikkusega.
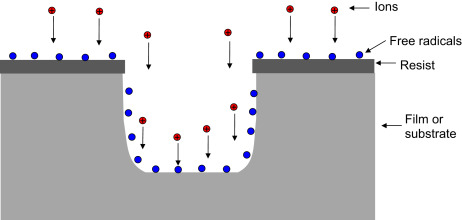
4. Etch-profiilide juhtimine
Enne kui plasmasöövitus pooljuhtide tootmises laialdaselt levis, kasutas enamikus vahvlimaterjalides mustri ülekandmiseks märgkeemilist söövitamist. Märgsöövitamine on aga isotroopne protsess (söövitamine igas suunas sama kiirusega). Kui objektide suurus kahaneb alla 3 µm, põhjustab isotroopne söövitus allalõiget, mis piirab märgsöövituse rakendamist.
Plasmaprotsessides pommitavad ioonid pidevalt vahvli pinda. Kas võrekahjustusmehhanismide või külgseina passiveerimismehhanismide kaudu võib plasmasöövitusega saavutada anisotroopsed söövitusprofiilid. Vähendades rõhku söövitusprotsessi ajal, saab ioonide keskmist vaba teed suurendada, vähendades seeläbi ioonide kokkupõrkeid parema profiili kontrollimiseks.
5. Söövituskiirus ja selektiivsus
Plasma ioonidega pommitamine aitab lõhkuda pinnaaatomite keemilisi sidemeid, paljastades need plasma tekitatud radikaalidele. See füüsikalise ja keemilise töötlemise kombinatsioon suurendab oluliselt söövitamise keemilise reaktsiooni kiirust. Söövituskiirus ja selektiivsus sõltuvad protsessi nõuetest. Kuna nii ioonidega pommitamine kui ka radikaalid mängivad söövitamisel otsustavat rolli ning raadiosageduslik võimsus saab kontrollida ioonide pommitamist ja radikaale, muutub raadiosageduslik võimsus söövituskiiruse reguleerimise võtmeparameetriks. RF-võimsuse suurendamine võib oluliselt suurendada söövituskiirust, mida arutatakse üksikasjalikumalt, mõjutades ka selektiivsust.
6. Lõpp-punkti tuvastamine
Ilma plasmata tuleb söövitamise lõpp-punkt kindlaks määrata aja või operaatori visuaalse kontrolliga. Plasmaprotsessides, kui söövitus kulgeb läbi pinnamaterjali, et alustada alusmaterjali (lõpp-punkti) söövitamist, muutub plasma keemiline koostis söövitamise kõrvalsaaduste muutumise tõttu, mis ilmneb emissiooni värvi muutumisest. Jälgides emissiooni värvi muutust optiliste anduritega, saab söövituse lõpp-punkti automaatselt töödelda. IC-tootmises on see väga väärtuslik tööriist.**




