
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Dislokatsioon SiC kristallides
SiC-substraadil võib olla mikroskoopilisi defekte, nagu keermestuskruvi dislokatsioon (TSD), keermeserva dislokatsioon (TED), alustasandi dislokatsioon (BPD) ja muud. Need vead on põhjustatud kõrvalekalletest aatomite paigutuses aatomi tasandil.
SiC kristallid kasvavad tavaliselt viisil, mis ulatub paralleelselt c-teljega või sellega väikese nurga all, mis tähendab, et c-tasapinda tuntakse ka alustasandina. Kristallides on kaks peamist dislokatsiooni tüüpi. Kui dislokatsioonijoon on põhitasandiga risti, pärib kristall dislokatsioonid idukristallilt epitaksiaalselt kasvanud kristallile. Neid dislokatsioone nimetatakse läbistavateks dislokatsioonideks ja neid võib Bernoulli vektori orientatsiooni alusel dislokatsioonijoone suhtes liigitada keermestusservade dislokatsioonideks (TED) ja keermeskruvi dislokatsioonideks (TSD). Dislokatsioone, kus nii dislokatsioonijooned kui ka Brönstedi vektorid on alustasandil, nimetatakse alustasandi dislokatsioonideks (BPD). SiC kristallidel võivad olla ka liitdislokatsioonid, mis on ülaltoodud dislokatsioonide kombinatsioon.
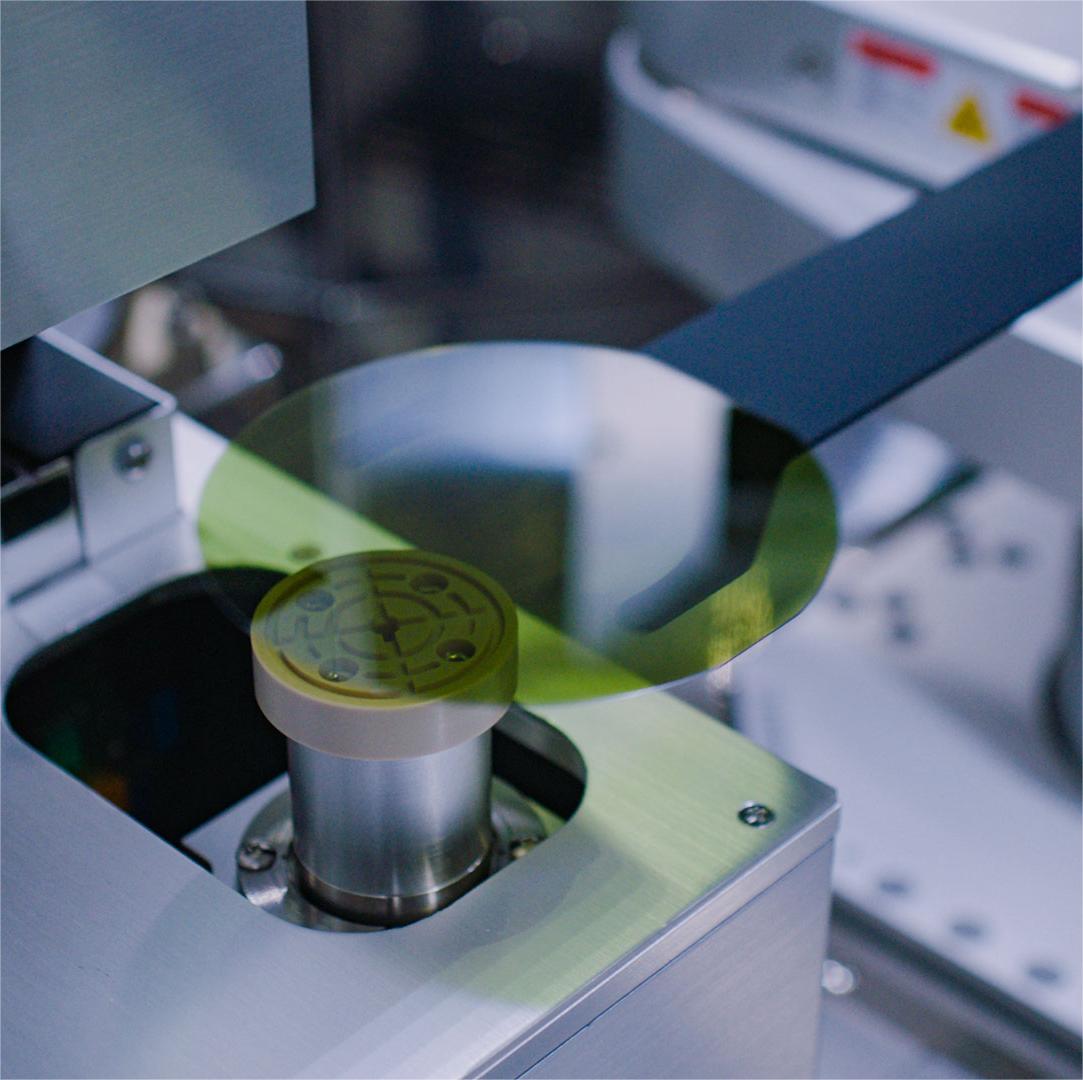
1. TED&TSD
Nii keermestatud dislokatsioonid (TSD) kui ka keermestatud serva dislokatsioonid (TED) kulgevad piki [0001] kasvutelge erinevate Burgersi vektoritega vastavalt <0001> ja 1/3<11-20>.
Nii TSD-d kui ka TED-id võivad ulatuda substraadist vahvli pinnale ja tekitada väikeseid süvenditaolisi pinnaelemente. Tavaliselt on TED-ide tihedus umbes 8000–10 000 1/cm2, mis on peaaegu 10 korda suurem kui TSD-de tihedus.
SiC epitaksiaalse kasvuprotsessi ajal ulatub TSD substraadist laiendatud TSD epitaksiaalse kihini, mis võib muutuda substraadi tasapinnal muudeks defektideks ja levida piki kasvutelge.
On näidatud, et SiC epitaksiaalse kasvu ajal muutub TSD substraadi tasapinnal virnastamiskihi vigadeks (SF) või porgandi defektideks, samas kui epitaksiaalses kihis olev TED muundub epitaksiaalse kasvu ajal substraadilt päritud BPD-st.
2. BPD
Põhitasandi dislokatsioonidel (BPD), mis asuvad SiC kristallide tasapinnal, on Burgersi vektor 1/3 <11-20>.
BPD-d ilmuvad SiC-plaatide pinnale harva. Need on tavaliselt koondunud substraadile tihedusega 1500 1/cm2, samas kui nende tihedus epitaksiaalses kihis on vaid umbes 10 1/cm2.
On arusaadav, et BPD-de tihedus väheneb SiC substraadi paksuse suurenemisega. Fotoluminestsentsi (PL) abil uurides näitavad BPD-d lineaarseid tunnuseid. SiC epitaksiaalse kasvuprotsessi käigus võib laiendatud BPD transformeerida SF-ks või TED-iks.
Ülaltoodust nähtub, et SiC substraadi vahvlil on defekte. Need vead võivad pärida õhukeste kilede epitaksiaalses kasvus, mis võib põhjustada ränikarbiidi seadme surmavaid kahjustusi. See võib kaasa tuua ränikarbiidi eeliste, nagu suur läbilöögiväli, kõrge pöördpinge ja madal lekkevool, kadumise. Lisaks võib see vähendada toote kvalifitseerimise määra ja tekitada ränikarbiidi industrialiseerimisele suuri takistusi töökindluse vähenemise tõttu.




